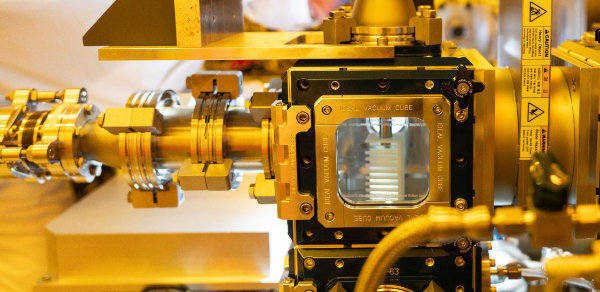
Tiheimpien puolijohdepiirien valmistus voi nopeutua yksinkertaisella keinolla: lisäämällä happea litografiaprosessiin. Belgialainen tutkimuslaitos imec on osoittanut, että EUV-litografiassa käytettävien metal-oxide-resistien valotusannosta voidaan pienentää jopa 20 prosenttia nostamalla happipitoisuutta valotuksen jälkeisessä lämpökäsittelyssä (post-exposure bake).
EUV-litografiassa valotusannos määrittää pitkälti, kuinka nopeasti piikiekot voidaan käsitellä skannerissa. Kun tarvittava annos pienenee, sama EUV-laite pystyy käsittelemään enemmän kiekkoja tunnissa. Tämä kasvattaa suoraan EUV-skannerien tuotantokapasiteettia, mikä on merkittävää, koska yksittäinen laite maksaa satoja miljoonia euroja.
Happi nopeuttaa resistin reaktiota
Imecin kokeissa tarkasteltiin metallioksidipohjainen resistiivikalvoja, joita pidetään lupaavina materiaaleina kaikkein pienimpien piirirakenteiden valmistuksessa ja erityisesti tulevassa High-NA EUV-litografiassa. Tutkimuksessa havaittiin, että kun lämpökäsittelyvaihe tehtiin ympäristössä, jossa happipitoisuus nostettiin normaalista 21 prosentista noin 50 prosenttiin, resistin valotusherkkyys parani 15–20 prosenttia.
Post-exposure bake on lämpökäsittely, joka tehdään EUV-valotuksen jälkeen ennen resistin kehitystä. Imec pystyi tutkimaan prosessin ympäristöolosuhteita BEFORCE-nimisellä tutkimusalustalla, jossa kiekon siirto ja bake-vaihe voidaan suorittaa tarkasti kontrolloidussa kaasukoostumuksessa.
Tulokset viittaavat siihen, että litografiaprosessin ympäristö – esimerkiksi kaasukoostumus – voi olla uusi tapa optimoida EUV-prosessia. Jos vaikutus voidaan hyödyntää tuotantotyökaluissa, se voisi parantaa EUV-skannerien läpäisykykyä ilman muutoksia itse valotuslaitteeseen.
EUV-litografiaa käytetään kaikkein pienimpien puolijohderakenteiden kuviointiin uusimmissa logiikkaprosesseissa ja muistipiireissä. Sitä hyödynnetään esimerkiksi transistorien gate-rakenteissa, kontakti- ja via-kerroksissa sekä kaikkein tiheimmissä metallikerroksissa, joissa johdinlinjojen väli on vain kymmeniä nanometrejä. EUV tulee sanoista extreme ultraviolet, ja menetelmä käyttää erittäin lyhytaaltoista valoa, jonka aallonpituus on noin 13,5 nanometriä. Lyhyt aallonpituus mahdollistaa huomattavasti pienempien kuvioiden muodostamisen kuin aiemmassa syväultraviolettilitografiassa (DUV), jossa käytetään tyypillisesti 193 nanometrin valoa.































