Markkinoilla on jo pitkään ollut flash-muisteja, joissa samaan piirikoteloon on istutettu useita siruja. Tähän asti nämä sirut on yhdistetty toisiinsa lankabondauksella. Nyt Toshiba on esitellyt ensimmäinen pinotun flash-muistinsa, jossa sirut liitetään toisiinsa TSV-läpivienneillä.
TSV-tekniikasta (Trhough Silicon Via) on useita etuja vanhaan bondaukseen verrattuna. Pystysuorien elektrodien avulla signaalit kulkevat sirujen läpi, mikä nopeuttaa muistin toimintaa ja pienentää tehonkulutusta.
Toshiban ensimmäinen pinottu TSV-piiri on 16 sirun yhdistelmä, jolla saadaan aikaan 256 gigatavun piiri. Piiri on kooltaan 14 x 18 -millinen ja sen paksuus on 1,9 milliä. Lisäksi tarjolle tuotiin 8 päällekkäin pinotun piirin version, jonka kapasiteetti on 128 gigatavua. Tämän piirin paksuus on 1,35 milliä.
Toshiban mukaan pinotun TSV-piirin I/O-datanopeus on yli 1 gigabitti sekunnissa. Tämä on nopeammin kuin missään matalajännitteisessä (1,2-1,8 volttia) flash-piirissä aiemmin. Tehonkulutus putoaa TSV-linkkien myötä 50 prosenttia pienemmäksi, yhtiö kertoo.
Toshiba aikoo esitellä uutuuttaan Flash Memory Summitissa Piilaakson Santa Clarassa ensi viikolla.











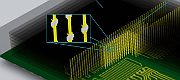
 ETN:n digitaalinen aikakauslehti ETNdigi 1/2026 on julkaistu. Uusi numero kokoaa yhteen elektroniikka-alan keskeisiä teknologiateemoja kvanttilaskennasta ja tekoälystä energiatehokkaaseen tehoelektroniikkaan, IoT-järjestelmiin ja ajoneuvojen latausinfrastruktuuriin.
ETN:n digitaalinen aikakauslehti ETNdigi 1/2026 on julkaistu. Uusi numero kokoaa yhteen elektroniikka-alan keskeisiä teknologiateemoja kvanttilaskennasta ja tekoälystä energiatehokkaaseen tehoelektroniikkaan, IoT-järjestelmiin ja ajoneuvojen latausinfrastruktuuriin.
 Nokian toimitusjohtaja Justin Hotard arvioi yhtiön Yhdysvaltain arvopaperimarkkinavalvoja SEC:lle toimittamassa Form 20-F 2025 -vuosiraportissa, että mobiiliverkkomarkkina ei ole lähivuosina varsinainen kasvuala. Hänen mukaansa markkinan odotetaan pysyvän lähinnä vakaana samalla kun Nokia keskittyy parantamaan liiketoiminnan kannattavuutta.
Nokian toimitusjohtaja Justin Hotard arvioi yhtiön Yhdysvaltain arvopaperimarkkinavalvoja SEC:lle toimittamassa Form 20-F 2025 -vuosiraportissa, että mobiiliverkkomarkkina ei ole lähivuosina varsinainen kasvuala. Hänen mukaansa markkinan odotetaan pysyvän lähinnä vakaana samalla kun Nokia keskittyy parantamaan liiketoiminnan kannattavuutta.



















